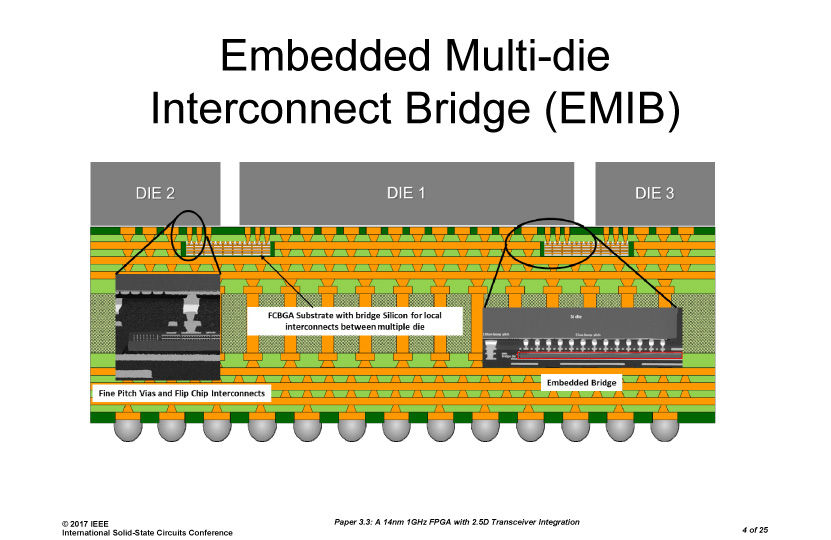
Intel on esitellyt ISSCC-tapahtumassa tulevaa Embedded Multi-die Interconnect Bridge- eli EMIB-teknologiaa. EMIB-teknologiaa tullaan käyttämään niin sanottujen 2,5D-piirien valmistuksessa ja sen uskotaan tarjoavan yhtiölle selvän edun kilpailijoiden käyttämiin interposer-ratkaisuihin nähden.
Interposer on yleensä yksinkertaisempi passiivisilla rakenteilla varustettu piisiru, joka asetetaan hartsialustan ja muiden piirien väliin, ja joka mahdollistaa erittäin leveiden väylien käytön esimerkiksi sille istutettujen grafiikkapiirin ja HBM-muistipiirien välillä.
Tällä hetkellä tuotantokäytössä olevat interposer-ratkaisut vaativat huomattavan suurikokoisen pii-interposerin, jolle jää väkisinkin hukkatilaa eri piirien ympärille. Hyvänä esimerkkinä tästä toimii esimerkiksi AMD:n Fiji-grafiikkapiiri. Fiji-grafiikkapiiri on pinta-alaltaan 596 neliömilliä ja sen kahdella sivulla on yhteensä neljä 40 mm²:n HBM-muistipinoa, mutta interposer, jolle ne on istutettu, on kooltaan peräti 1011 mm².
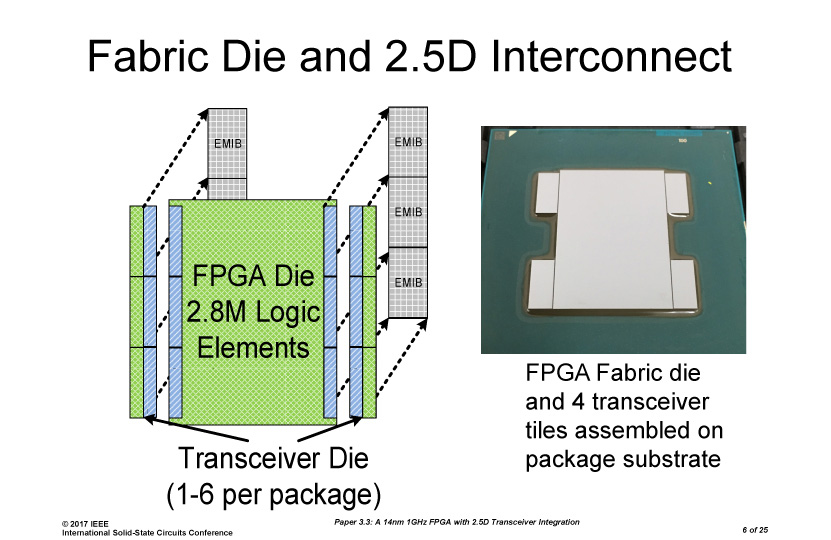
Intelin EMIB-teknologia korvaa suurikokoiset interposer-ratkaisut suoraan hartsialustaan integroiduilla pienikokoisilla siltapiireillä. Teknologiaa hyödyntävissä piireissä tullaan käyttämään 55 mikrometrin kontakteja EMIB-siltapiirien kohdalla, mutta muut piirin osat voivat edelleen käyttää suuremman jännitteen mahdollistavia 110 µm:n kontakteja. EMIB-siltapiirejä voi Intelin tämän hetkisten suunnitelmien mukaan olla 1 – 6 per hartsialusta ja yhtiön käyttämässä esimerkkipiirissä niitä oli käytössä neljä.
Lähde: PC Watch
Anteeksi offtopic heti kärkeen, mutta odotan erään toisen sivuston kopion ja kielenmuunnokset tähän 😀
Onko jotain toisia sivustoja?
Tämähän kuulostaa oikeansuuntaiselta kehitykseltä, nuo interposerit kun on tosiaan todella valtavan kokoisia ainakin olivat tuossa ensimmöisen sukupolven HBM näyttiksessä.
Nyt sitten Intel voisi julkaista prosessorin, jossa olisi hieman järeämpi gpu ja HBM muistia tällaisella EMIBillä sille gpulle se 8 gigaa ja prossulle lisäksi 8 gigaa. Sellainen prossu johonkin läppäriin, niin riittäisi hetkeksi.
Onkohan tämä nyt sitä Intel+AMDGPU prossua varten suunniteltu. Hittoku tietäis olenko sarkastinen vai en.
Riippumatta siitä onko tuollaista Intel+AMD MCM:ää tulossa vastaus on Ei.
Itsellä herää kysymys kuinka herkkä tuo systeemi on asennusvirheille kun tuossahan voi olla CPU ydin jonka alla on kaksi eritavalla paineeseen reagoivaa alustaa niin kun haastelija ruuvaa tollaiselle bare die prossulle jäähyn niin onko vaara että liiallinen paine murtaa sen CPU ytimen kun sen alla on kaksi eritavalla puristuvaa pintaa.
Uutiseen lisätty lyhyt kuvaus interposerista
Eikö tää ole vähän liian diippiä settiä tälle sivustolle? Kyse ei ole kuluttajatuotteesta. Mä vähän epäilen että monikaan täällä ei juuri ymmärrä tuollaisten päälle mitään.
No eipä tää mikään kodinkonesivusto olekkaan.
Eikö harrastelija/asiantuntijasivuston tehtävä olekin uutisoida alan merkittävistä tapahtumista samalla auttaen lukijoita ymmärtämään mistä niissä onkaan kyse? Eli parantiko vaiko huonontiko uutinen ymmärrystä?
Aika paljon kiinnostavia ja merkittäviä asioita jäisi ihmisiltä kuulematta, mikäli uutisoitaisiin vain lopputuotteista. Tämäkin teknologia löytänee ennen pitkää tiensä kuluttajatuotteisiin potentiaalisesti laskien niiden hintaa.
Kyllä noista interposereista on jauhettu niin maan valtavasti esim juurikin tuon fijin yhteydessä, että mielestäni tämmöisestä uutisointi on vähintäänkin paikallaan.
Itse olen ehdottomasti tälläisten uutisten kannalla. Ehdotan jopa, että techissä voisi julkaista artikkeleita, missä selvitetään ns. "kansan kielellä", kuinka jotkin tekniikat toimii. Vähän samankaltaisia kuin esimerkiksi LTT:llä on Tech Quickie. Kuitenkaan tämän sarjan tietoa on hyvin rajoittuneesti saatavilla suomeksi ja Lontooksi saa sitten tietää vähän laajemmin termistöä ennen kuin jostain jotain selvää saa.
Hyvä uutinen, näitä lisää kiitos.
Pieni muokkaus: ”jolle jää väkisinkin hukkatilaa eri piirien ympärille.”
Ei pelkästään ympärille, vaan myös piirin alle. Jos katsot kuvaa, ei EMIB-tekiniikassa piirien alla ole kaikkialla näitä interposerin paloja. Interposer-tekniikassa taasen vaaditaan interposer koko piirin alle, vaikka liitäntöjä olisi vain 20% tuosta alasta.
Kyllä me pyrimme uutisoimaan merkittävistä pc-komponentteihin liittyvistä aiheista ja tekniikoista. Ei niillä klikkejä kerätä tuhansia, mutta ovat kuitenkin relevantteja teknisestä näkökulmasta.
Vastataan vähän vanhaan, mutta käsittääkseni HBM-muisteissa noita kontakteja on koko piirin alalla, eli siinä se piirin alainen osuus ei sinänsä mene hukkaan.
edit: siitä en tiedä käytetäänkö HBM:n ja esim Fijin ja GP100:n kohdalla noita pienempiä kontakteja, mutta muistaakseni ainakin Fijissä koko piirin hartsialustan takapuoli on sen verran täynnä pinnejä että isompia ei ainakaan olisi voinut käyttää edes