
Intel esitteli aiemmin tällä viikolla Intel Architecture Day -tapahtumassaan muun muassa seuraavan sukupolven suorituskykyiset Sunny Cove -x86-ytimet sekä Gen11-grafiikka-arkkitehtuurin. Näiden lisäksi tapahtumassa oli myös esillä uusi Foveros-paketointiteknologia ja ensimmäinen sitä soveltava järjestelmäpiiri.
Intelin valmistuslinjoilla on käytössä useita rinnakkaisia valmistusprosesseja. Vaikka nimellisesti puhutaan esimerkiksi 14 nanometrin piireistä, on prosessorit ja piirisarjat valmistettu eri prosesseilla. Nyt Compute- ja IO-painotteiset prosessit ovat saaneet rinnalleen uuden ”Foveros”-prosessin, jolla valmistetaan saman nimistä paketointia käyttäviä tuotteita.
Foveros on 3D-paketointiteknologia, joka hyödyntää aktiivista interposeria. Se on suunnattu piireille, joille yhtiön nykyinen EMIB-siltapiiriteknologia ei ole riittävä ratkaisu esimerkiksi kaistatarpeen vuoksi. Reititystehtävien lisäksi aktiivinen interposer voi sisältää esimerkiksi piirisarjan (Platform Controller Hub, PCH) tai erilaisia I/O-yhteyksiä sen päälle pinottujen piirien käyttöön. Tämän hetkisissä prototyyppipiireissä interposer on valmistettu 22 nanometrin valmistustekniikalla ja sen päältä löytyy 10 nanometrin prosessilla tehty järjestelmäpiiri sekä muistia POP-paketoinnissa (Package-on-Package). Teknologia mahdollistaa kuitenkin myös useamman kuin yhden piirin asentamisen interposerin päälle ja mahdollisen muistipiirin alle.
Foveros-prototyypistä löytyvä 10 nanometrin prosessilla valmistettava järjestelmäpiiri, joka sisältää muun muassa yhden Sunny Cove -prosessoriytimen, neljä tarkemmin määrittelemättömän sukupolven Atom-prosessoriydintä, GT2-tason Gen11-grafiikkaohjaimen ja 4 x 16-bittisen LPDDRR4-muistiohjaimen. Intel on tehnyt aiemminkin ns. hybridi-x86-prosessoreita, joissa käytetään useampaa eri tyyppistä x86-ydintä, mutta ne ovat olleet erittäin harvassa.
Alapuolelta löytyvän PCH- tai IO-piirin tehtäviä hoitavan interposerin tai POP-paketoidun muistin tarkempia teknisiä yksityiskohtia ei paljastettu, mutta alustan kerrottiin tukevan PCIe M.2- ja UFS-standardeja tallennustilalle.
Koko Foveros-prototyyppipiiri on kooltaan 12×12 millimetriä ja sen kerrotaan kuluttavan valmiustilassa vain 2 milliwattia energiaa. Piiri on ominaisuuksiensa perusteella suunattu mobiilikäyttöön, mutta asiasta tiedotettaneen myöhemmin, kun se julkaistaan vuoden 2019 aikana. Intelin mukaan prosessori on toteutettu nimeltä mainitsemattoman asiakkaan toiveiden mukaiseksi ratkaisuksi ja etenkin vain 2 milliwatin kulutuksen valmiustilassa olleen tärkeä kriteeri piirin kohdalla. Jim Kellerin mukaan yhtiöllä on työn alla myös useita muita Foveros-teknologiaa hyödyntäviä tuotteita.



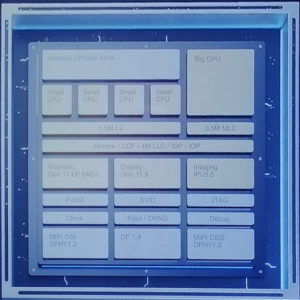
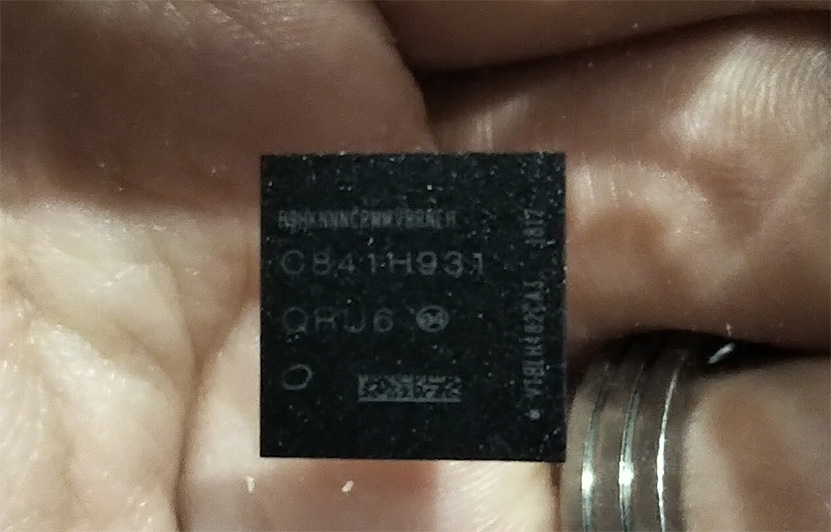
Aktiivinen interposer… sitähän on pitkään spekuloitu myös AMD:lle, mutta sen piti olla "liian vaikea" ja "liian kallis" toteuttaa joidenkin mielestä. Nyt intel tuo sen mobiilipiireille? Ei taidakkaan olla niin kallis kuin osa kuvittelee. 🙂
Mielenkiintoisia aikoja.
Ei aktiivinen interposer automaattisesti ole liian vaikea tai kallis, vaan se usean GPU-chipletin vaatima olisi todennäköisesti liian monimutkainen ja/tai kallis.
Hieman OT mutta mitä tuolla PCH:lla nykyisin edes on? Kello ja jotain kuvankäsittelyä että näyttösignaalin saa liittimelle? Ylimääräisiä PCI-e linjoja? Tajusin että olen hieman tipahtanut kelkasta tämän suhteen, ei taida ainakaan kymmeneen vuoteen emolevyn piirisarjat tehdä mitään kuin tarjota kytkennällisyyttä?
katso liitettä 172062
Tuossa on Intelin Z390-alustakaavio, "Intel Z390 Chipset" on PCH. AMD:lla piirisarjalla ei tainnut olla mitään todellista muuta funktiota kuin tarjota lisää liittimiä/linjoja
Näyttösignaalilla tietenkin tarkoitin iGPU:ta, eikö se mene PCH:n kautta? Kiitos tuosta kaaviosta.
Juu ymmärsin mitä tarkoitit, ei mene, vaan suoraan prosessorilta menee vedot emon näyttöliittimiin
Aika yllättävää. Olisin mututuntumalla väittänyt että kaikki menee DMI:n kautta.
Ei sitä kautta kierrätetä yhtään mitään ylimääräistä, toi Intelin kaavio on aika hyvä näyttään tosiaan mistä mikäkin menee heillä
Eipä tuollainen kerrosvoileipätoteutus nykyisenlaisilla jäähdytysjärjestelyillä voikaan juuri mobiilipiirejä suuritehoisemmilla toimia, kun lämmöt karkaavat. Olihan joskus jotain spekulaatiota piirin sisäisistä jäähdytyskanavoinneista tai jostain vartaavasta, että 3D-piirit saisi jäähtymään tosin.
Ei spekulaatiota vaan ihan toimivaksi todistettu teknologia. Ei tosin ilmeisesti ihan halpa toteuttaa.
Olikos näissä jotain ongelmia että kanavat joko pikkuhiljaa kuluu suuremmiksi ja nesteet karkaa tai että ne tukkeutuu ja sit ei nesteet kierrä koko alueella enää. Evm, luin varmaan 5v sit asiasta.
Taitaa tulla uuteen Apple TV:hen ensin. Ehkä tehokkaampiin kun kehittyy.
Kuvastaisi sitä että alkutuotannon kustannukset on korkeita, linjastoja ei voida alustalle antaa tarpeeksi, sutta ja sekundaa tulee liikaa tai joku näiden kolmen yhdistelmästä. Jos interposer maksaa satkun ei sen avulla kannata rakentaa seitsemän kympin prossua. Myöskään ei kannata markkinoida massamallia ja sitten kertoa että saadaan näitä valmiiksi 300 kappaletta viikossa.
Onkohan tuossa jokin väärinymmärrys. Kaikkialla muualla on väitetty, että ensin tulisivat Sunny Covet työpöytäkäyttöön ja vasta myöhemmin Xeonit.
Sunny Cove -jutut eivät kyllä sinänsä liity tähän ketjuun. :rolleyes:
Sinänsä liittyvät että tässäkin on Sunny Cove ja riippuen mihin aikaan ensi vuonna tuo tulee ulos, se saattaa olla jopa ensimmäinen Sunny Cove -tuote.
Intel ei kertonut mielestäni missään välissä missä järjestyksessä nuo on tulossa markkinoille