Uutiset
LIVE: io-techin tekniikkakatsaus-podcast (2/2019)
io-techin suorana lähetettävässä videopodcastissa keskustellaan viikon kiinnostavimmista tietotekniikka- ja mobiilimaailman tapahtumista.

io-techin tekniikkakatsaus-podcast esitetään tänään perjantaina 11. tammikuuta noin klo 14:00 alkaen suorana live-streamina Twitchissä ja Youtubessa. Äänessä ovat tuttuun tapaan io-techin perustajakaksikko Sampsa Kurri ja Juha Kokkonen sekä lisäksi tuoreista näytönohjain- ja prosessorijulkaisuista keskustelemassa Petrus Laine.
Tekniikkakatsauksessa käymme läpi ajankohtaiset IT-alan asiat ja uutuustuotteet kuluneen viikon ajalta, kerromme mitä päivityksiä io-techissä on mahdollisesti luvassa lähitulevaisuudessa sekä valotamme artikkelien tekemisen ja io-techin pyörittämiseen liittyviä taustatarinoita. Katsojat voivat osallistua lähetykseen interaktiivisesti Twitchin keskusteluikkunan välityksellä.
io-techin viikon tekniikkakatsaus on jälkikäteen katsottavissa tai kuunneltavissa:
LIVE: io-techin tekniikkakatsaus-podcast (2/2019)
io-techin suorana lähetettävässä videopodcastissa keskustellaan viikon kiinnostavimmista tietotekniikka- ja mobiilimaailman tapahtumista.
Thermaltake laajentaa muistimarkkinoille ja esitteli nestejäähdytetyt WaterRam RGB -muistit
Kookkaan nestejäähdytysblokin mahdollistaman tilan kautta Thermaltake on luonut muisteilleen poikkeuksellisen näyttävän RGB-valaistuksen.

Thermaltake tunnetaan kenties parhaiten jäähdyttimistään ja koteloistaan, mutta yhtiöllä on listoillaan myös useita muita oheislaitteita. Nyt tuotekirjo kasvaa yhtiön omilla muisteilla.
Thermaltaken ensimmäiset muistit saivat nimekseen WaterRam RGB Liquid Cooling Memory. Kuten jo nimikin kertoo, kyse on nestejäähdytetyistä muisteista, jotka on varustettu nykytrendien vaatimalla RGB-valaistuksella. WaterRam RGB -muistit tulevat saataville 16 (8 Gt x 2) ja 32 Gt:n (8 Gt x 4) kapasiteeteilla DDR4-3200-nopeudella. Hynixin C-die-muistipiirien viiveiksi on määritelty 16-18-18-38 ja ne tukevat Intelin XMP 2.0 -muistiprofiileita.
Muistien erikoisuus on niiden jäähdytysratkaisu. Itse muistikammat on varustettu 2 mm paksuilla alumiinisilla lämmönlevittäjillä ja muistikampojen päälle asennetaan erillinen nestejäähdytysyksikkö. Nestejäähdytysyksikön mitat ovat 53,8 x 37 x 133,8 mm ja se saa virtansa 9-pinnisestä USB 2.0 -liittimestä emolevyllä.
Vaikka nestejäähdytyksen kontaktipinta muistikampoihin jää verrattain pieneksi, kertoo Thermaltake mitanneensa jopa 37 % matalampia lämpötiloja. Yhtiön mittausten mukaan DDR4-3200-muistit ilman lämmönlevittäjiä toimisivat 48-asteisina, lämmönlevittäjillä nestejäähdytysblokki paikallaan, mutta pumppu pois päältä, 45,8-asteisina ja pumpun ollessa käynnissä 30,2-asteisina.
RGB-valaistus on sijoitettu nestejäähdytysyksikköön, jonka koon vuoksi voidaan puhua poikkeuksellisen näyttävästä valotykityksestä. Valaistus tukee Thermaltaken RGB Plus -ympäristöä ja se on yhteensopiva Asuksen AuraSyncin, Gigabyten RGB Fusion Readyn, MSI:n Mystic Light Syncin ja ASRockin Polychrome RGB:n kanssa.
Muistit tulevat saataville välittömästi Thermaltaken omasta verkkokaupasta 32 gigatavun kitteinä ja 16 Gt:n kittien odotetaan saapuvan myyntiin lähiaikoina. 32 Gt:n kitti on hinnoiteltu yhtiön verkkokaupassa 439,99 dollariin.
Thermaltake laajentaa muistimarkkinoille ja esitteli nestejäähdytetyt WaterRam RGB -muistit
Kookkaan nestejäähdytysblokin mahdollistaman tilan kautta Thermaltake on luonut muisteilleen poikkeuksellisen näyttävän RGB-valaistuksen.
EVGA Nu Audio laajentaa yhtiön tuotevalikoimaa ensimmäistä kertaa äänikortteihin
Vaikka Nu Audio kantaa EVGA:n nimeä, löytyy sen takaa brittiläinen äänitekniikan veteraani Audio Note.

Äänikorttirintamalla eletään hyvin pitkälti hiljaiseloa lähinnä Creative Labsia lukuunottamatta. Nyt areenalle saadaan uusi haastaja, kun näytönohjaimilla nimensä rakentanut EVGA julkisti ensimmäisen äänikorttinsa CES 2019 -messuilla.
EVGA Nu Audio on EVGA:n ensimmäinen äänikortti. Talon sisällä kehitetystä teknologiasta ei ole kuitenkaan kyse, vaan äänikortin toteutuksesta on vastuussa brittiläinen Audio Note. Audio Notella on takanaan yli 30 vuotta kokemusta korkealaatuisista äänilaitteistoista.
Äänikortin sydämenä sykkii Xmosin 32-bittinen, XS2-arkkitehtuuriin xCore 200 -prosessori, jota käytetään Nu Audion tapauksessa DSP-piirinä. Opamp-vahvistimet ovat vaihdettavat ja oletuksena linjaulostulossa on käytössä Analog Devicesin ADI AD8056 ja kuulokeliitännässä ADI OP275. Kuulokelinjoille on lisäksi täysin erillinen Maxim DS1882-piiri, joka mahdollistaa kuulokkeiden äänenvoimakkuuden säännön analogisesti mukana tulevan sovelluksen avulla. Ominaisuudesta on hyötyä lähinnä DSD-ääniraitojen toistossa, sillä niiden kohdalla äänenvoimakkuutta ei ole mahdollista säätää digitaalisesti.
EVGA Nu Audion DAC-piirinä toimii AKM Semiconductorin AK4493, jonka signaali/kohina-suhteeksi luvataan 123 dB. PCM-äänentoisto onnistuu maksimissaan 32-bittisenä 384 kHz:n näytteenottotaajuudella ja DSD-puolella tuettuna on 11,29 MHz:n näytteenottotaajuus. Analogisen signaalin digitaaliseksi kääntävinä ADC-piireinä on linjasisääntulossa AKMS:n AK5572 (121 dB, 32 bit / 384 kHz) ja mikrofonilinjassa Cirrus Logicin CS5346 (103 dB, 24 bit / 192 kHz).
Nu Audion I/O-paneelista löytyy RCA-linjaulostulot, 6,3 mm:n kuulokeliitäntä, 3,5 mm:n linjasisääntulot ja mikrofoniliitäntä sekä optinen S/PDIF-liitäntä. EVGA:n äänikortista saakin ulos vain stereosignaalia, ellei käytetä 5.1-signaalin mahdollistavaa optista ulostuloa.
Äänikortissa käytetään Audio Noten itsensä kehittämiä, nimenomaan audiokäyttöön suunniteltuja vastuksia ja kondensaattoripuolelta löytyy Audio Noten omien lisäksi WIMA:n kondensaattoreita, Panasonicin FC-sarjaa ja Nichiconin solid state -tyyppisiä kondensaattoreita. Äänikortti ottaa virtansa SATA-virtaliittimestä.
EVGA Nu Audio saapuu myyntiin 16. tammikuuta. EVGA:n edustajat ovat kertoneet hinnaksi 250 dollaria, mutta se varmistettaneen vielä erikseen viimeistään julkaisupäivänä.
Lähde: EVGA
EVGA Nu Audio laajentaa yhtiön tuotevalikoimaa ensimmäistä kertaa äänikortteihin
Vaikka Nu Audio kantaa EVGA:n nimeä, löytyy sen takaa brittiläinen äänitekniikan veteraani Audio Note.
Xiaomi julkisti edullisen Redmi Note 7 -älypuhelimen 48 megapikselin kameralla
Kiinassa alle 200 euron hintaluokkaan sijoittuva Note 7 tarjoaa erittäin kovat rautaominaisuudet.

Kiinalainen Xiaomi on julkistanut odotetusti uuden edulliseen hintaluokkaan sijoittuvan Redmi Note 7 -älypuhelimensa. Hintaluokka huomioiden laite on varustettu erittäin kilpailukykyisellä raudalla. Samalla yritys ilmoitti, että Redmi tulee tästedes operoimaan selkeämmin omana brändinään, joka tarjoaa äärimmäisen vastineen rahoille.
Redmi Note 7:n tekniikka on alle 200 euron hintaluokassa todella pätevää. 6,3-tuumainen FullHD-näyttö on varustettu pienellä kameran kokoisella näyttölovella ja suorituskyvystä vastaa Snapdragon 660 -järjestelmäpiiri. Takakamera perustuu Samsungin 48 megapikselin kuvasensoriin, joka hyödyntää Quad Bayer -suodatinta ja neljän pikselin yhdistämistä yhdeksi suureksi 1,6 um pikseliksi. Viiden megapikselin lisäkameraa hyödynnetään tekoälytoiminnoissa ja syvyysterävyysefektissä. Mukavan kokoinen 4000 mAh akku latautuu lisävarusteena myytävällä 18 watin laturilla täyteen tunnissa ja kolmessa vartissa. Käyttöjärjestelmäversiosta ei ole tietoa.
Redmi Note 7 tekniset tiedot:
- Ulkomitat: 159,2 × 75,2 x 8,1 mm
- Paino: 186 grammaa
- Rakenne: metallikuoret, Gorilla Glass 5 etu- ja takalasi
- 6,3″ LCD IPS -näyttö, 19,5:9-kuvasuhde, 1080 x 2340 pikseliä, 409 PPI
- Qualcomm Snapdragon 660 -järjestelmäpiiri
- 3, 4 tai 6 Gt RAM-muistia
- 32 tai 64 Gt tallennustilaa, micro-SD-muistikorttipaikka
- LTE-yhteydet, Dual SIM
- WiFi 802.11 a/b/g/n/ac dual-band, Bluetooth 5.0, infrapunalähetin
- GPS, GLONASS, BeiDou
- Kaksoistakakamera
- 48 megapikselin Samsung ISOCELL Bright GM1 -sensori 0,8 um pikselikoolla, f1.8, 1080p 60 FPS videokuvaus
- 5 megapikselin apukamera (AI ja syvyystiedot)
- 13 megapikselin etukamera
- 4000 mAh akku, USB Type-C, 18 watin QC4-pikalataustuki (laturi lisävaruste)
- Android
Redmi Note 7:n toimitukset alkavat Kiinassa tammikuun 15. päivä. Värivaihtoehtoja on kolme – Blue, Twilight Gold ja Black. 3 & 32 Gt:n perusversion suositushinta on 999 yuania eli alle 130 euroa. 6 & 64 Gt:n huippuversio maksaa vastaavasti 1399 yuania (180 euroa). On hyvin mahdollista että laite saapuu myös Suomeen, mutta hintaluokka on todennäköisti noin 100 euroa Kiinan hintoja korkeampi.
Xiaomi julkisti edullisen Redmi Note 7 -älypuhelimen 48 megapikselin kameralla
Kiinassa alle 200 euron hintaluokkaan sijoittuva Note 7 tarjoaa erittäin kovat rautaominaisuudet.
Julkaisematon Nokia 8.1 Plus -älypuhelin OnLeaksin renderöintivuodossa
Kuvavuodossa esiintyvä Nokia 8.1:n Plus-malli on yrityksen ensimmäinen näyttöreiällä varustettu puhelin.

Päivitys: Kuvien puhelin saattaa olla myös tuleva Nokia 6.2 -malli, joka olisi ainakin mallistoon peilaten loogisempi vaihtoehto.
OnLeaks (Steve Hemmerstoffer) jatkaa kovaa vuototahtiaan ja tällä kertaa vuorossa ovat ennennäkemättömän Nokia 8.1 Plus -mallin renderöinnit. Kuvat ja video on julkaistu yhteistyössä 91Mobiles-sivuston kanssa.
Kuvien perusteella Nokia 8.1 Plus on HMD:n ensimmäinen puhelin, jossa käytetään näyttöloven sijaan kamerareikää näytössä. Kuvissa etukamera on sijoitettu näytön vasempaan ylänurkkaan. Muotoilullisia eroavaisuuksia ensi viikolla Suomessa myyntiin tulevaan Nokia 8.1 -malliin nähden ovat pyöreämmiksi muotoillut kyljet sekä hieman suurempi kamerakyhmy, johon on sijoitettu myös salamavalo.
Laitteen näyttökoon kerrotaan olevan 6,22 tuumaa ja ulkomitat 156,9 x 76,2 x 7,9 mm, eli pari milliä Nokia 8.1:tä enemmän pituusuunnassa ja puolisen milliä leveyssuunnassa. Maininnan arvoisina seikkoina sormenjälkitunnistin sijaitsee takakuoressa ja yläpäädyssä on 3,5 mm kuulokeliitäntä. Tarkemmista teknisistä ominaisuuksista ei ole vielä tietoa.
Nokia 8.1 Plussan julkaisuajankohdasta ei ole vielä tarkempaa tietoja, mutta 91Mobilesin mukaan lisätietoja on luvassa lähiaikoina. io-techin arvion mukaan on epätodennäköistä, että 8.1 Plus saapuisi Suomen markkinoille, jos rautapuolen ominaisuudet eivät tarjoa merkittäviä parannuksia 8.1-malliin nähden.
Julkaisematon Nokia 8.1 Plus -älypuhelin OnLeaksin renderöintivuodossa
Kuvavuodossa esiintyvä Nokia 8.1:n Plus-malli on yrityksen ensimmäinen näyttöreiällä varustettu puhelin.
AMD antoi ensimaistiaisen 3. sukupolven Ryzen-työpöytäprosessoreista (Zen 2)
AMD:n 3. sukupolven Ryzen-prosessorit perustuvat samaan 8-ytimiseen Zen 2 -pikkupiiriin, kuin Rome-palvelinprosessori ja ne tulevat toimimaan kaikissa AM4-emolevyissä BIOS-päivityksen myötä.

AMD:n toimitusjohtaja Lisa Sun CES 2019 -keynote on juuri päättynyt. Esityksessä nähtiin muun muassa maailman ensimmäinen 7 nanometrin pelinäytönohjain, mutta kenties mielenkiintoisin osuus oli ensimmäiset maistiaiset 3. sukupolven Ryzen-prosessoreista.
3. sukupolven Ryzen-prosessorit perustuvat Zen 2 -arkkitehtuuriin ja ne valmistetaan TSMC:n 7 nanometrin valmistusprosessilla. Prosessorit tulevat toimimaan kaikilla AM4-emolevyillä BIOS-päivityksen myötä, mutta PCI Express 4.0 -tuen hyödyntäminen vaatii luonnollisesti uuden emolevyn.
AMD ei ole luopunut yhden sirun taktiikastaan, vaan Rome-palvelinprosessorin tapaan uusi Ryzen käyttää 8-ytimistä Zen 2 -pikkupiiriä eli chiplettiä, jonka rinnalla on erillinen 14 nanometrin I/O-piiri. Uutisen kuvassa suurempi siruista on I/O-piiri ja pienempi Zen 2 -pikkupiiri.
Su antoi suorituskyvystä sen verran ensimaistiaista, että Cinebenchissä 8-ytiminen prototyyppi-Ryzen oli käytännössä tasoissa Intelin Core i9-9900K -prosessorin kanssa, Ryzenin viedessä potin 17 pisteen erolla (2057 vs 2040). Su mainitsi tosin ennen testiä, ettei Ryzen toiminut testikokoonpanossa lopullisilla kellotaajuuksillaan.
AMD tulee julkaisemaan kolmannen sukupolven Ryzen-työpöytäprosessorit vuoden puolivälin tienoilla. Yhtiö tulee kertomaan prosessoreista lisää lähempänä julkaisua.
Lähde: AMD CES 2019 @ YouTube
AMD antoi ensimaistiaisen 3. sukupolven Ryzen-työpöytäprosessoreista (Zen 2)
AMD:n 3. sukupolven Ryzen-prosessorit perustuvat samaan 8-ytimiseen Zen 2 -pikkupiiriin, kuin Rome-palvelinprosessori ja ne tulevat toimimaan kaikissa AM4-emolevyissä BIOS-päivityksen myötä.
AMD:n Radeon VII on maailman ensimmäinen 7 nanometrin pelinäytönohjain
Vaikka AMD aiemmin totesi Vega 20:n tulevan vain ammattilaispuolelle, on Radeon VII lähes varmasti täysin sama 7 nanometrin siru.

AMD:n toimitusjohtajan Lisa Sun CES 2019 -keynote on parhaillaan käynnissä. Su on esitellyt tapahtumassa hetki sitten maailman ensimmäisen 7 nanometrin pelinäytönohjaimen.
Radeon VII on maailman ensimmäinen 7 nanometrin prosessilla valmistettua grafiikkapiiriä käyttävä pelinäytönohjain. VII on toisen sukupolven Vega-arkkitehtuuriin perustuva ja todennäköisimmin kyseessä on sama Vega 20 -grafiikkapiiri, kuin Radeon Instinct -sarjan tuoreimmissa malleissa, vaikka AMD aiemmin sanoikin sen olevan tulossa vain ammattilaiskäyttöön. Vaikka VII on selvästi johdettu Vega II:sta, puheessa se lausutaan ”seven”.
Radeon VII:ssä on käytössä 60 Compute Unit -yksikköä ja se toimii parhaimmillaan 1,8 GHz:n kellotaajuudella. 4096-bittisen väylän myötä näytönohjaimessa on muistikaistaa 1 Tt eli 1024 Gt/s ja sen päästä löytyy 16 Gt HBM2-muistia.
AMD:n mukaan näytönohjain olisi 25 % Radeon RX Vegaa nopeampi samalla tehonkulutuksella, mutta osittain kiitos suuremman muistikaistan hyötyohjelmissa suorituskyky on noussut AMD:n testien mukaan 27 – 62 % ja pelinopeus 25 – 42 %. Suorassa vertailussa GeForce RTX 2080 -näytönohjaimeen VII on käytännössä yhtä nopea Battlefield V- ja FarCry 5 -peleissä ja selvästi nopeampi Strange Brigadessa.
Radeon VII saapuu myyntiin 7. helmikuuta ja sen veroton suositushinta on 699 dollaria, eli sama kuin NVIDIAn GeForce RTX 2080 -näytönohjaimella.
Lähde: AMD CES 2019 @ YouTube
AMD:n Radeon VII on maailman ensimmäinen 7 nanometrin pelinäytönohjain
Vaikka AMD aiemmin totesi Vega 20:n tulevan vain ammattilaispuolelle, on Radeon VII lähes varmasti täysin sama 7 nanometrin siru.
Video: Kokeilimme Lidlin halpaa pelinäppäimistöä
Kävimme ostamassa joulun alla Lidlistä 38 euron SilverCrest-pelinäppäimistön ja tutustumme videolla sen ominaisuuksiin.

Lidlin pelinäppäimistöä mainostetaan puolimekaanisena, mutta käytetyistä kytkimistä ei kuitenkaan ollut tarjolla tarkempaa tietoa. 37,99 euron hinnalla kyseessä on markkinoilla olevia mekaaanisia näppäimistöjä edullisempi vaihtoehto, joten kävimme mielenkiinnosta ostamassa näppäimistön ja tutustuimme pikaisesti sen ominaisuuksiin.
Videolla käydään läpi näppäimistön ominaisuudet, kuten värivalaistus ja kiskotaan pihdeillä yksi kytkin irti näppäimistöstä, jotta pääsimme tutustumaan tarkemmin sen toimintamekanismiin. Käytössä todettiin olevan kumikupu- eli membrane-kytkimet ja kytkimeen on upotettu pieni metalliklipsu, joka pitää painettaessa äänekkään klik-äänen ja antaa pienen tuntopisteen.
Jos pidit videosta, käy tykkäämässä videota, tilaa io-techin YouTube-kanava, anna kommenteissa palautetta ja kehitämme videokonseptia lisää, kiitos!
Video: Kokeilimme Lidlin halpaa pelinäppäimistöä
Kävimme ostamassa joulun alla Lidlistä 38 euron SilverCrest-pelinäppäimistön ja tutustumme videolla sen ominaisuuksiin.
Corsairilta uutta valaistus- ja yhteystekniikkaa hyödyntäviä pelihiiriä ja -näppäimistö
Uudet valaisu- ja yhteystekniikat tulevat löytymään Corsairin tulevista pelituotteista.

Oheislaitevalmistaja Corsair on esitellyt CES-messuilla uusia tekniikoita, joita se hyödyntää tuoreimmissa pelituotteissaan.
Toinen Corsairin uutuustekniikoista on Slipstream, joka on uusi 2,4 GHz:n tajuutta käyttävä langaton yhteys pelihiirien, näppäimistöjen ja kuulokkeiden yhteydenpitoon tietokoneen kanssa. Slipstreamin kerrotaan tarjoavan virheettömämpää, nopeampaa ja vahvempaa signaalia kuin aikaisemmat tekniikat. Corsairin itse kehittämä protokolla mahdollistaa pakettien lähettämisen kahdesti millisekunnissa sekä tarvittessa älykkään uudelleenlähettämisen. IFS-ominaisuus tutkii jatkuvasti ympäristön radiotaajuuksia ja pystyy alle millisekunnin viiveellä vaihtamaan vähiten ruuhkaiselle taajuudelle. Yhteyden kantavuuden kehutaan parantuneen jopa kaksinkertaiseksi aiempaan nähden ja se toimii nyt jopa 20 metrin etäisyydeltä. Yhteen tietokoneeseen liitettävään langattomaan vastaanottimeen voi yhdistää useita yhteensopivia laitteita.
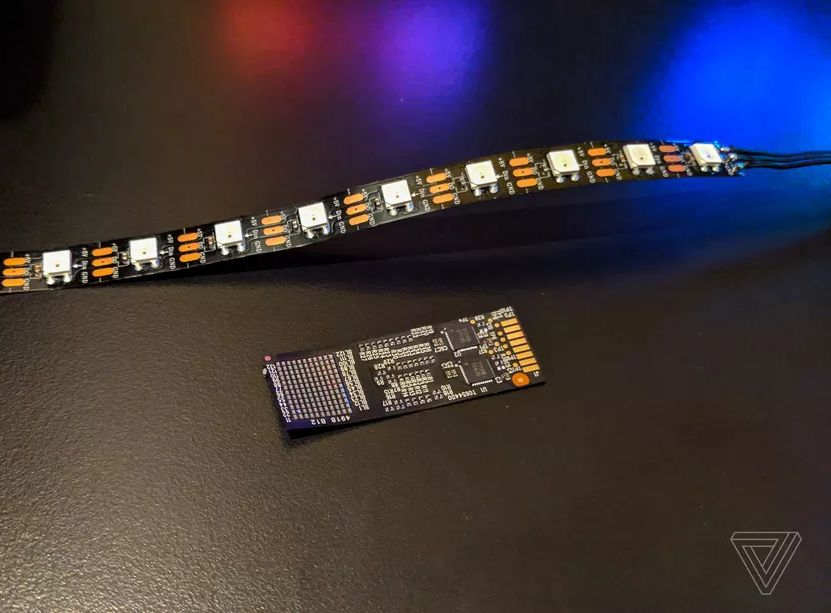
Tekniikoista toinen on nimeltään Capellix ja se on kehitysaskel laitteissa käytettävien LED-valojen toteutuksessa. Capellix-ledit ovat merkittävästi pienempiä kuin tavalliset pintaliitosledit (tilavuus 0,2 mm3 vs. 2,8 mm3) ja niiden LED-siru kiinnitetään suoraan piirilevylle ilman suurikokoista SMD-paketointia. Primaxin kanssa kehitetty tekniikka mahdollistaa Corsairin mukaan jopa 60 % kirkkaamman, 60 % energiatehokkaamman, virrankulutukseltaan 40 % alhaisemman sekä 35 % pitkäikäisemmän valaistusratkaisun. Pienemmän kokonsa ansiosta Capellix-ledejä voi sijoittaa huomattavasti tiheämpään, joka mahdollistaa korkeamman ”valoresoluution”.
Kyseisiä tekniikoita hyödyntäviä uutuustuotteita ovat Harpoon Wireless RGB -hiiri (kuvassa vasemmalla), Ironclaw RGB -hiiri (oikealla), M65 RGB Elite -hiiri (keskellä) sekä uusi K68 RGB Elite Slipstream -näppäimistö. Myöhemmin luvassa on myös Slipstream-yhteyttä hyödyntäviä pelikuulokkeita.
M65 RGB Elite on claw-tyyppiselle otteelle muotoiltu alumiinirunkoinen langallinen hiiri, joka käyttää PWM 3391 -sensoria (18 000 CPI) ja painaa 97-115 grammaa lisäpainojen määrästä riippuen. Ironclaw RGB on nimestään poiketen muotoiltu kämmenotteelle (palm grip) ja se käyttää samaa PMW 3391 -sensoria sekä painaa 105 grammaa. Harpoon Wireless RGB on muotoilultaan pelkistetty langaton pelihiiri, joka käyttää uutta Slipstream-yhteystekniikkaa sekä painaa vain 99 grammaa. Yhdellä latauksella akun luvataan kestävän jopa 60 tuntia.
K68 RGB Elite Slipstream on langaton ja RGB-valaistu versio K68-pelinäppäimistöstä. Sen varustukseen kuuluu mm. erilliset multimediakontrollit sekä kuusi erillistä funktionäppäintä näppäimistön vasemmassa reunassa.
M65 RGB Eliten suositushinta on 69,99 euroa, Ironclawn ja Harpoonin 59,99 euroa ja K68 RGB Elite -näppäimistön hinta ilmoitetaan myöhemmin.
Lähteet: Corsair (1)(2), TechPowerUp, The Verge
Corsairilta uutta valaistus- ja yhteystekniikkaa hyödyntäviä pelihiiriä ja -näppäimistö
Uudet valaisu- ja yhteystekniikat tulevat löytymään Corsairin tulevista pelituotteista.
Intel julkaisi F-sarjan Core-prosessorit ilman integroitua grafiikkaohjainta (Coffee Lake Refresh)
Grafiikkaohjaimen poistaminen käytöstä mahdollistaa osittain viallisten sirujen hyödyntämisen, mutta prosessoreiden hinnassa muutos ei näy vaan hinnoittelu vastaa grafiikkaohjaimella varustettuja sisarmalleja.

Intel on julkistanut CES 2019 -messujen yhteydessä liudan uusia prosessorimalleja kuluttajamarkkinoille. Merkittävin ero aiempiin malleihin löytyy F-sarjasta, jonka prosessoreista on kytketty grafiikkaohjain pois käytöstä.
Intel on julkaissut CES 2019 -messuilla uusia F-sarjan Core-prosessoreita. Uudet prosessorimallit perustuvat muiden 8. ja 9. sukupolven prosessoreiden tapaan Coffee Lake- ja Coffee Lake Refresh -arkkitehtuureihin. Voit lukea mallien tarkemmat tiedot alta löytyvästä taulukosta.
Prosessorit valmistetaan edelleen 14 nanometrin valmistusprosessilla ja niiden merkittävin ero sisarmalleihinsa on käytöstä poistettu grafiikkaohjain. Kyse on todennäköisesti Intelin tarpeesta paikata kapasiteettiongelmiaan, sillä grafiikkaohjaimen poistaminen käytöstä mahdollistaa sen osalta viallisten sirujen käytön myytävissä tuotteissa. GT2-tason grafiikkaohjain kattaa noin neljänneksen 8-ytimisen Coffee Lake Refresh -sirun pinta-alasta.
Intel ei julkaissut hintatietoja prosessoreista eilen niiden julkistuksen yhteydessä, mutta on nyt päivittänyt prosessoreidensa suositellut kuluttajahinnat ja sisällyttänyt mukaan myös uudet mallit. Säästöä grafiikkaohjaimettoman prosessorin ostamisesta ei kuitenkaan ole näillä näkymin tulossa, sillä ainakin Intelin päässä hinnat ovat identtiset vastaavien grafiikkaohjaimella varustettujen mallien kanssa.
Virallisesti julkistettujen prosessorimallien lisäksi Intelin ARK-tietokantaan on ilmestynyt uusi Core i3-8100F -prosessori, joka vastaa odotetusti sisarmalliaan grafiikkaohjainta lukuunottamatta. 4-ytiminen prosessori ei tue Hyper-threading-teknologiaa tai Turbo-kellotaajuuksia. Prosessorin peruskellotaajuus on 3,6 GHz.
AnandTech kertoo lisäksi, että Dell on listannut verkkosivuillaan erään tietokoneen prosessorivaihtoehdoiksi vielä julkistamattomat Core i7-9700:n, i3-9100:n ja Pentium Gold 5420:n. Valitettavasti verkkosivut eivät paljasta prosessoreiden tarkkoja tietoja, mutta i7-9700 on 8-ytiminen ja sen Turbo-kellotaajuus on K- ja KF-malleja 200 MHz matalampi 4,7 GHz. i3-9100 on neliytiminen ja sen Turbo-kellotaajuus on maksimissaan 4,2 GHz. Prosessorit eivät tue HT-teknologiaa. Pentium Gold 5420 on tuplaydinprosessori, joka kykenee suorittamaan HT-teknologian avulla neljää säiettä. Sen peruskellotaajuus on 3,8 GHz.
Intel julkaisi F-sarjan Core-prosessorit ilman integroitua grafiikkaohjainta (Coffee Lake Refresh)
Grafiikkaohjaimen poistaminen käytöstä mahdollistaa osittain viallisten sirujen hyödyntämisen, mutta prosessoreiden hinnassa muutos ei näy vaan hinnoittelu vastaa grafiikkaohjaimella varustettuja sisarmalleja.




















